Wafer Sort Test Process
- Home
- /
- Wafer Sort Test Process
Wafer Sort Test Process
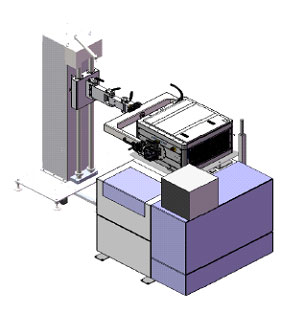

What ProPowertek can do for you?
▶ ProPowertek offers multiple testing platforms combined with low, room, and high temperature environments to provide customers with analog and mixed-mode wafer testing services.
▶ In addition to standard wafer testing solutions, ProPowertek also provides frame prober testing for dies attached to metal frames after wafer dicing.
▶ Besides current trimming, ProPowertek also offers laser trimming processes to meet different customer requirements.
W/S Wafer Testing Process
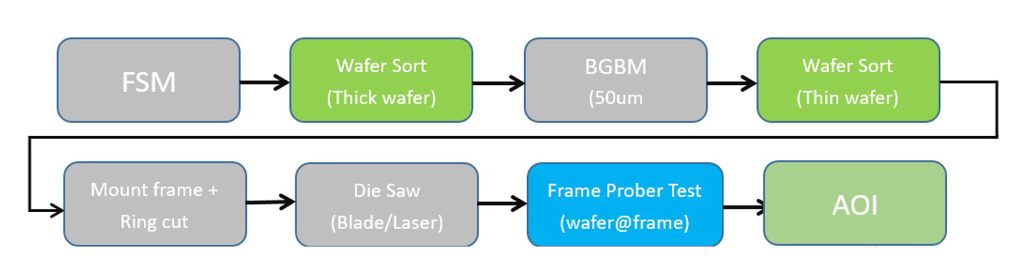
The Superiority of ProPowertek
▶ ProPowertek provides comprehensive turnkey solutions covering thick wafer testing, thin wafer testing, and frame prober testing, integrated with FSM/BGBM processes.
▶ We offer multiple testing platforms, including AccoTEST, Teradyne, and Chroma, giving customers a variety of choices.
▶ Automotive chips demand extremely high reliability and functional safety (e.g., ISO 26262). Even a single potentially defective die entering the module can cause serious consequences. ProPowertek’s testing platforms support screening methods such as DPAT (Dynamic Part Average Testing) and GDBC (Good Dies in Bad Cluster).
▶ To meet customer data requirements, we provide various test output formats, such as STDF, TXT, and E-MAP.
▶ Our team includes test program and probe card development engineers who assist customers with rapid development, problem-solving, and stable mass production.
Case Sharing
Application of DPAT and GDBC
▶ DPAT (Dynamic Part Average Testing) offers two modes: “Mean & Sigma” and “Robust Mean & Sigma.”
▶ GDBC (Good Dies in Bad Cluster) removes good dies that have potential risks according to customer-defined rules.
Application
⏺︎ The testing platform enables the DPAT function; after wafer testing, GDBC rules are applied to remove “good” dies that may have potential risks, generating a new test map.
⏺︎ According to customer requirements, we can provide the original test map, DPAT map, GDBC map, or the final combined test map individually.

